介绍金手指封装(正反面)的设计方法,常用于内存卡和连接器等。
1、 顶部贴片设计,正面布局。
2、 关于正面焊盘的设计方法,网上已有不少优秀的详细教程,这里不再赘述。主要涉及的图层有:起始层、顶层阻焊层和顶层钢网层。如果对焊盘相关知识不够了解,请自行查阅资料进行学习。
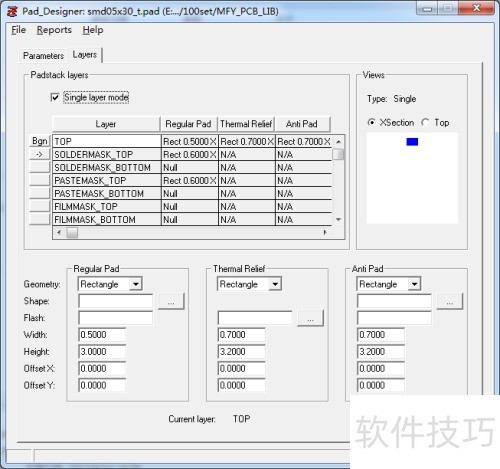
3、 底面焊盘设计(Bottom Pad)
4、 在Allegro进行封装设计时,默认将焊盘放置于顶层。而对于金手指封装,通常会同时包含正面与反面的焊盘。反面焊盘的设计方式与正面类似,但需要专门为bottom层的焊盘设计一个flash符号。此flash主要涉及常规焊盘、底部阻焊层(soldermask bottom)和底部锡膏层(pastemask bottom)的设计。如果遇到异形焊盘,则还需要额外设计热释垫(thermal relief)和防焊开窗(anti pad)的符号以满足具体需求。
5、 反面Pad主要使用的层为:bottom layer、soldermask bottom和pastemask bottom。需要注意的是,切换到bottom layer作为首层的操作方法为:先取消勾选signal layer mode,然后将top layer设为null,同时把bottom layer设置为设计中的bottom pad flash。这样可以确保正确显示反面Pad的相关内容,并方便进行后续操作与设计调整。
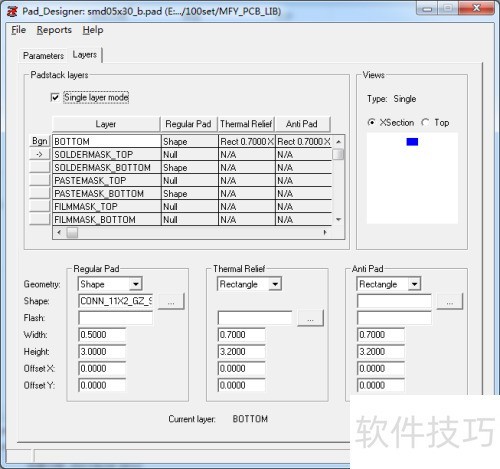
6、 可以使用垫片
7、 创建Allegro封装时,依据pin序号添加对应的顶层和底层焊盘,随后按常规封装完成设计即可。



